|
К сожалению, электронная микроскопия ограничена в
своих возможностях по исследованию и диагностике поверхности. Наряду
с огромными плюсами, которые она имеет (например, возможность иметь
в каждый момент информацию о всей поверхности, возможность реализации
in-situ экспериментов), существует несколько неоспоримых недостатков.
К таковым относятся, в первую очередь, необходимость достаточного
вакуума для получения относительно хорошего разрешения (нет возможности
исследовать жидкостные объекты), отсутствие возможности просмотра
больших образцов, достижение атомного разрешения в критических для
поверхности условиях, когда энергия пучка электронов достигает величины
до 300 КэВ.
В связи с этим, неоспоримым достижением стало открытие 1981 году
(момент опубликования в Phys. Rev. Lett.) Генрихом Рорером и Гердом
Биннигом метода сканирующей туннельной микроскопии, которая положила
начало развитию сканирующей зондовой микроскопии. Работая над микроскопическими
исследованиями роста и электрических свойств тонких диэлектрических
слоев в лаборатории IBM в Рюмликоне в Швейцарии, авторы думали использовать
туннельную спектроскопию. В то время были известны работы Янга о
полевом излучающем микроскопе, Томпсона по туннелированию в вакууме
с управляемым остриём, так что мысль о способности измерения с помощью
эффекта туннелирования не только спектроскопических свойств поверхности,
но и её рельефа, была основана на трудах немалого количества исследователей.
Необходимо было решить множество технических проблем: как избежать
механических вибраций, приводящих к столкновению острия с поверхностью
(мягкая подвеска), какие силы действуют между образцом и остриём
(к созданию АСМ), как перемещать остриё с такой высокой точностью
(пьезоэлектрик), как приводить образец и остриё в контакт (специальный
держатель), как избежать тепловых флуктуаций (использование не нитевидных
кристаллов с большими упругими константами, низкие темепературы),
форма острия и её получение (на поверхности основного острия существуют
миниострия - сначала использовались они, потом с помощью самого
процесса туннелирования - сильное вакуумное электрическое поле при
напряжении всего лишь несколько вольт вызвало миграцию ионов (испарение)).
И вот когда авторы получили атомное изображение давно волновавшей
всех поверхности кремния с периодом 7 на 7, - в 1986 году мир отметил
их Нобелевской премией. Множество трудностей, которые усложняли
исследование образцов в СТМ, побудили к 1986 году разработать их
первый атомно-силовой микроскоп, который мог использовать те самые
силы взаимодействия между образцом и остриём, которые так мешали
в случае СТМ. Атомно-силовой микроскоп позволял проводить измерения
не только в вакууме, но и в атмосфере, заранее заданном газе и даже
сквозь плёнку жидкости, что стало несомненным успехом для развития
биологической микроскопии. Так была положено начало эры сканирующей
зондовой микроскопии. Вскоре была представлена микроскопия ближнего
поля, которая задействовала оптические волны для разрешения объектов
до 10 ангстремм.
Современная атомно-силовая микроскопия активно используется во всем
мире для исследования как полимеров, так и любых других материалов.
Очень широкое развитие она получила по исследованию вирусов, клеток,
генов в биологии, - там с ней связывают большие надежды.
 |
Преимущества и недостатки сканирующей зондовой
микроскопии
по отношению к другим методам диагностики поверхности
Принципиальным свойством электронной, оптической, ядерной микроскопий
является, то что каждая частица, провзаимодействовавшая с образцом,
будь то атом или субатомные объекты, является зондом. Однако, у
данного метода есть свои минусы и плюсы. Так квантовый принцип неопределённости,
гласящий, что определение одновременно импульса и координаты объекта
исследования, возможно только с определённой точностью, заставляет
увеличивать импульс регистрирующих частиц (энергию), что связано
с созданием специальных технологий. Увеличение импульса регистрирующих
частиц (например, электроны в ПЭМ достигают энергий до 1000 КэВ)
создаёт проблемы с устойчивостью объекта к разрушению. Однако плюсом
является тот факт, что одновременно получается информация сразу
с относительно большого участка поверхности, что позволяет использовать
данный метод для in-situ исследований. Так же главным недостатком
данного вида микроскопии можно назвать условие относительного вакуума,
для получения более менее качественного изображения.
Атомно-силовая микроскопия позволяет обрабатывать образцы в атмосфере,
однако, главным её недостатком является отсутствие одновременной
информации о всей поверхности, - в каждый момент времени мы имеем
информацию только от участка непосредственно регистрируюемого зондом.
Но несмотря на это АСМ позволяет использовать in-situ измерения.
Атомно-силовая микроскопия позволяет получать информацию о поверхностном
заряде, о поверхностной емкости, о поверхностной проводимости, о
магнитных свойствах. Позволяет измерять эти параметры даже сквозь
плёнку жидкости.
Принципиальное устройство микроскопа АСМ
 Сканирующая
зондовая микроскопия - это метод исследования поверхности, основанный
на взаимодействии микрозонда (кантилевера в случае АСМ) с поверхностью
образца. Микрозонд или кантилевер (англ. - балка) представляет собой
кремниевую пластинку (3х1.5х0.3 мм) с торчащей из торца балкой (как
прямоугольной, так и треугольной формы), - на конце балки находится
шип, конец которого и зондирует поверхность. Сканирующая
зондовая микроскопия - это метод исследования поверхности, основанный
на взаимодействии микрозонда (кантилевера в случае АСМ) с поверхностью
образца. Микрозонд или кантилевер (англ. - балка) представляет собой
кремниевую пластинку (3х1.5х0.3 мм) с торчащей из торца балкой (как
прямоугольной, так и треугольной формы), - на конце балки находится
шип, конец которого и зондирует поверхность.
Кантилеверы разделяются на жёсткие и мягкие, - по длине балки, а
характеризуется это резонансной частотой колебаний кантилевера.
Процесс сканирования микрозондом поверхности может происходить как
в атмосфере или заранее заданном газе, так и в вакууме, и даже сквозь
плёнку жидкости. СЗМ измеряет как нормальное к поверхности отклонение
зонда (субангстремное разрешение) так и латеральное - одновременно.Для детектирования отклонения используется полупроводниковый лазер с
длинной волны 670 нм и оптической мощностью 0,9 мВт. Лазерный луч
направляется на обратную к по отношению к поверхности сторону кантилевера
(на самый кончик), которая покрыта специальным алюминиевым зеркальным
слоем для наилучшего отражения, и отраженный луч попадает в специальный
четырёхсекционный фотодиод. Таким образом, отклонения кантилевера
приводят к смещению луча лазера относительно секций фотодиода, -
изменение разностного сигнала с фотодиода и будет показывать амплитуду
смещения кантилевера в ту или иную сторону. Такая система позволяет
измерять отклонения лазера в угле 0,1", что соответствует отклонению
кантилевера на угол 2o10-7 рад.
детектирования отклонения используется полупроводниковый лазер с
длинной волны 670 нм и оптической мощностью 0,9 мВт. Лазерный луч
направляется на обратную к по отношению к поверхности сторону кантилевера
(на самый кончик), которая покрыта специальным алюминиевым зеркальным
слоем для наилучшего отражения, и отраженный луч попадает в специальный
четырёхсекционный фотодиод. Таким образом, отклонения кантилевера
приводят к смещению луча лазера относительно секций фотодиода, -
изменение разностного сигнала с фотодиода и будет показывать амплитуду
смещения кантилевера в ту или иную сторону. Такая система позволяет
измерять отклонения лазера в угле 0,1", что соответствует отклонению
кантилевера на угол 2o10-7 рад.
Сканирование поверхности может происходить двумя способами, - сканирование
кантилевером и сканировение подложкой. Если в первом случае движения
вдоль исследуемой поверхности совершает кантилевер, то во втором
относительно неподвижного кантилевера движется сама подложка. Для
сохранения режима сканирования, - кантилевер должен находиться вблизи
поверхности, - в зависимости от режима, - будь то режим постоянной
силы, или постоянной высоты, существует система, которая могла бы
сохранять такой режим во время процесса сканирования. Для этого
в электронную схему микроскопа входит специальная система обратной
связи, которая связана с системой отклонения кантилевера от первоначального
положения. Уровень связи (рабочая точка) кантилевер-подложка задается
заранее, и система обратной связи отрабатывает так, чтобы этот уровень
поддерживался постоянным независимо от рельефа поверхности, а сигнал,
характеризующий величину отработки и является полезным сигналом
детектирования.
Образец (поверхность) и кантилевер сближаются с помощью шагового
двигателя до тех пор пока поверхность и кантилевер не начнут взаимодействовать,
что приведёт к такому смещению лазерного луча на секциях фотодиода,а
значит к такому разностному току, что обратная связь прекратит сближение.
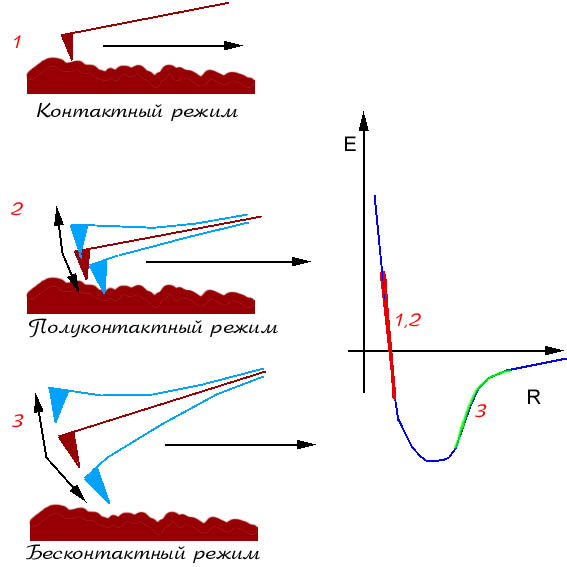 Кантилевер
непосредственно связан с четырёхобкладочной пьезотрубкой, подавая
напряжение на противоположные обкладки, можно соответственно менять
изгиб трубки, а значит и область сканирования кантилевера (горизонтальтное
отклонение пьезотрубки) вдоль соответственно оси абсцисс и оси ординат.
Внутри трубки находиться также пьезоэлемент, который отвечает за
смещение кантилевера вдоль нормали к поверхности, то есть оси аппликат.
При сканировании поверхности задается рабочая точка, физический
смысл которой есть величина выдвижения пьезотрубки по отношению
в максимальной амплитуде (обычно около 50 %). Обратная связь отрабатывает
величину выдвижения пьезотрубки для поддержания режима (постоянной
силы или постоянной высоты, в случае СТМ - постоянного туннельного
тока) сканирования. В случае сканирования подложкой такая система
присоединена к подложке. Кантилевер
непосредственно связан с четырёхобкладочной пьезотрубкой, подавая
напряжение на противоположные обкладки, можно соответственно менять
изгиб трубки, а значит и область сканирования кантилевера (горизонтальтное
отклонение пьезотрубки) вдоль соответственно оси абсцисс и оси ординат.
Внутри трубки находиться также пьезоэлемент, который отвечает за
смещение кантилевера вдоль нормали к поверхности, то есть оси аппликат.
При сканировании поверхности задается рабочая точка, физический
смысл которой есть величина выдвижения пьезотрубки по отношению
в максимальной амплитуде (обычно около 50 %). Обратная связь отрабатывает
величину выдвижения пьезотрубки для поддержания режима (постоянной
силы или постоянной высоты, в случае СТМ - постоянного туннельного
тока) сканирования. В случае сканирования подложкой такая система
присоединена к подложке.
Существуют контактный, безконтактный и полуконтактный или резонансный
режимы сканирования поверхности. Контактный метод заключается в
том, что кантилевер непосредственно касается поверхности и повторяет
её форму по мере прохождения поверхности. Бесконтактный и полуконтактный
режим характеризуются дополнительным условием сканирования, которое
позволяет осуществить более щадящее и более тонкое сканирование
поверхности. Кантилевер жестко связывается с отдельным пъезоэлементом
и колеблется со своей резонансной частотой. При взаимодействии с
поверхностью сбивается фаза, и специальный синхронный детектор старается
выровнять частоту с помощью сигнала обратной связи. Таким образом,
теперь детектируется кроме отклонения амплитудного также отклонение
фазовое. В этом режиме кантилевер как бы постукивает по поверхности.
|

 Сканирующая
зондовая микроскопия - это метод исследования поверхности, основанный
на взаимодействии микрозонда (кантилевера в случае АСМ) с поверхностью
образца. Микрозонд или кантилевер (англ. - балка) представляет собой
кремниевую пластинку (3х1.5х0.3 мм) с торчащей из торца балкой (как
прямоугольной, так и треугольной формы), - на конце балки находится
шип, конец которого и зондирует поверхность.
Сканирующая
зондовая микроскопия - это метод исследования поверхности, основанный
на взаимодействии микрозонда (кантилевера в случае АСМ) с поверхностью
образца. Микрозонд или кантилевер (англ. - балка) представляет собой
кремниевую пластинку (3х1.5х0.3 мм) с торчащей из торца балкой (как
прямоугольной, так и треугольной формы), - на конце балки находится
шип, конец которого и зондирует поверхность. детектирования отклонения используется полупроводниковый лазер с
длинной волны 670 нм и оптической мощностью 0,9 мВт. Лазерный луч
направляется на обратную к по отношению к поверхности сторону кантилевера
(на самый кончик), которая покрыта специальным алюминиевым зеркальным
слоем для наилучшего отражения, и отраженный луч попадает в специальный
четырёхсекционный фотодиод. Таким образом, отклонения кантилевера
приводят к смещению луча лазера относительно секций фотодиода, -
изменение разностного сигнала с фотодиода и будет показывать амплитуду
смещения кантилевера в ту или иную сторону. Такая система позволяет
измерять отклонения лазера в угле 0,1", что соответствует отклонению
кантилевера на угол 2o10-7 рад.
детектирования отклонения используется полупроводниковый лазер с
длинной волны 670 нм и оптической мощностью 0,9 мВт. Лазерный луч
направляется на обратную к по отношению к поверхности сторону кантилевера
(на самый кончик), которая покрыта специальным алюминиевым зеркальным
слоем для наилучшего отражения, и отраженный луч попадает в специальный
четырёхсекционный фотодиод. Таким образом, отклонения кантилевера
приводят к смещению луча лазера относительно секций фотодиода, -
изменение разностного сигнала с фотодиода и будет показывать амплитуду
смещения кантилевера в ту или иную сторону. Такая система позволяет
измерять отклонения лазера в угле 0,1", что соответствует отклонению
кантилевера на угол 2o10-7 рад.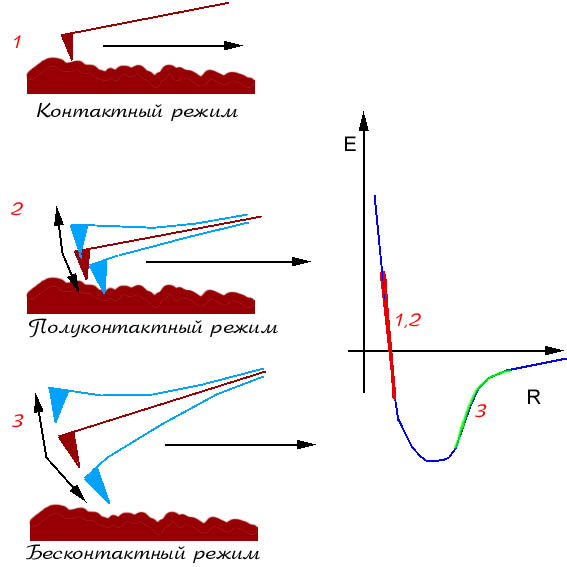 Кантилевер
непосредственно связан с четырёхобкладочной пьезотрубкой, подавая
напряжение на противоположные обкладки, можно соответственно менять
изгиб трубки, а значит и область сканирования кантилевера (горизонтальтное
отклонение пьезотрубки) вдоль соответственно оси абсцисс и оси ординат.
Внутри трубки находиться также пьезоэлемент, который отвечает за
смещение кантилевера вдоль нормали к поверхности, то есть оси аппликат.
При сканировании поверхности задается рабочая точка, физический
смысл которой есть величина выдвижения пьезотрубки по отношению
в максимальной амплитуде (обычно около 50 %). Обратная связь отрабатывает
величину выдвижения пьезотрубки для поддержания режима (постоянной
силы или постоянной высоты, в случае СТМ - постоянного туннельного
тока) сканирования. В случае сканирования подложкой такая система
присоединена к подложке.
Кантилевер
непосредственно связан с четырёхобкладочной пьезотрубкой, подавая
напряжение на противоположные обкладки, можно соответственно менять
изгиб трубки, а значит и область сканирования кантилевера (горизонтальтное
отклонение пьезотрубки) вдоль соответственно оси абсцисс и оси ординат.
Внутри трубки находиться также пьезоэлемент, который отвечает за
смещение кантилевера вдоль нормали к поверхности, то есть оси аппликат.
При сканировании поверхности задается рабочая точка, физический
смысл которой есть величина выдвижения пьезотрубки по отношению
в максимальной амплитуде (обычно около 50 %). Обратная связь отрабатывает
величину выдвижения пьезотрубки для поддержания режима (постоянной
силы или постоянной высоты, в случае СТМ - постоянного туннельного
тока) сканирования. В случае сканирования подложкой такая система
присоединена к подложке.